
一、玻璃基板简介
在高端先进封装领域,台积电凭借CoWoS生产技术和多样化产品组合占据领先地位,其 CoWoS-S在AI芯片市场主导地位显著。该技术采用 ABF载板作为IC载板,带有TSV的硅晶圆作为中介层,构建起三维互连体系。
然而,CoWoS-S封装发展正面临性能瓶颈,Si Interposer存在面积受限问题,有机中介层又面临翘曲困扰。而玻璃基板有望突破这些困境,与 RDL(和LSI) 搭配的玻璃中介层,能有效解决当前难题。并且,ABF 载板在积层增加时良率下滑严重,玻璃芯 IC 载板不仅可减层 25%,还能凭借薄玻璃芯获取高速信号 SI 收益,为封装技术升级带来新方向。
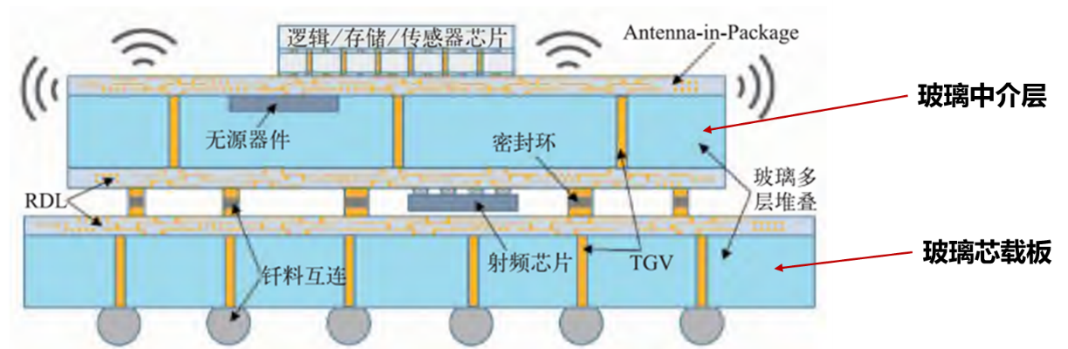
Source:《芯片三维互连技术及异质集成研究进展》(钟毅等,2023)
二、玻璃基板下游应用及市场
人工智能与大模型高性能计算领域发展迅猛,对性能提升需求迫切,玻璃基板凭借自身优势,有望在此率先获得大量投入。在 MEMS、射频、CIS、Mini/Micro LED、IPD 等技术领域,玻璃基板技术持续突破,已在IPD领域实现批量出货。随着技术成熟和成本降低,其应用范围还将拓展至笔记本电脑、移动设备芯片等领域。
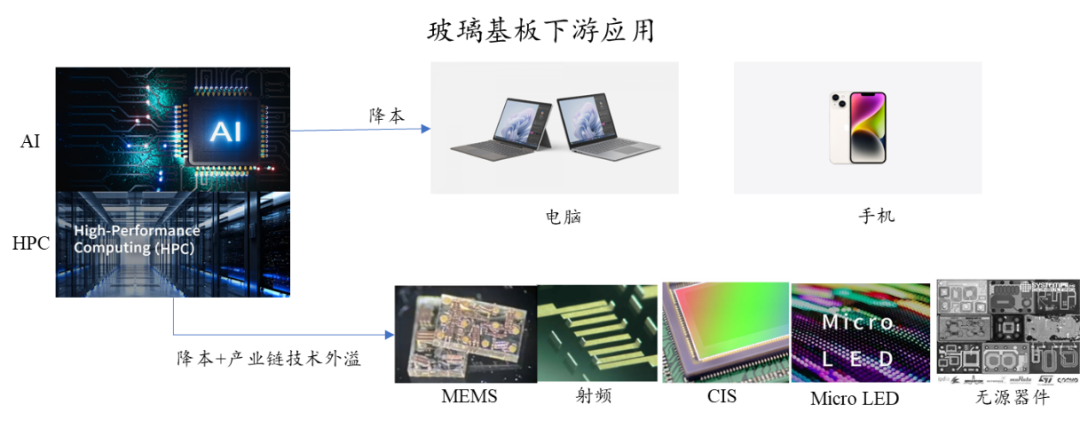
据Yole 乐观预测,若更多IC 设计/IDM企业采用玻璃基板,且相关企业实现量产,2025年全球玻璃基板市场规模可达2980万美元,2029年有望升至2.12亿美元,市场潜力巨大。
三、玻璃基板面临挑战
尽管玻璃基板在性能和成本方面相比硅材料、有机材料优势明显,但从实验室走向量产的过程中困难重重。在技术层面,长期可靠信息匮乏,建立完整数据库需多年积累;玻璃的光学特性导致测量信号易失真或丢失。成本居高不下,产业生态尚未完善。
制造环节问题也不少,微裂纹、金属化填充、线宽线距、曲翘以及散热等都是亟待攻克的难题。

四、产业化进度
国际上,Intel和Absolics玻璃基板产业化方面进展突出。Intel深耕玻璃基板技术近十年,2023年推出的玻璃载板适用于人工智能和数据中心,计划2026- 2030年量产,并投入超10亿美元建设研发产线。Absolics 成立于 2021 年,与佐治亚理工学院合作紧密,其玻璃基板面向高端芯片领域,可集成多种芯片和无源器件。
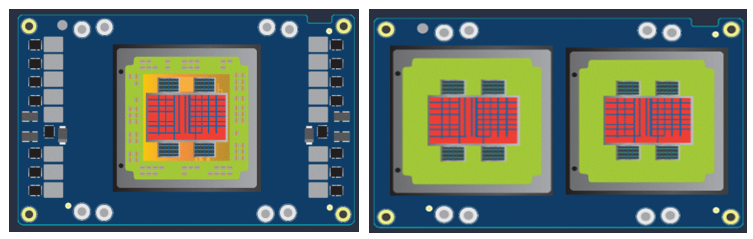
传统IC载板(左)与Absolics的玻璃基板(右)对比
Source:Absolics
众多 Fab、先进封装企业、IC 载板企业以及下游应用企业如苹果、AMD 等纷纷加大对玻璃基板的投入,在全产业链的推动下玻璃基板的产业化将大大加速。
国内安捷利美维公司产线和产品良率相对稳定,可承接小批量订单和样板制作。云天半导体、佛智芯等企业也在积极研发并进行小批量试产,虽技术与国际领先水平有差距,但发展势头强劲。
五、玻璃基板核心步骤及方案
玻璃基板制造主要包含 TGV 通孔、TGV 金属填充和 RDL 三个核心步骤。
1、TGV通孔
TGV 通孔制备中,激光诱导刻蚀法因加工品质优良,受到国内外头部企业青睐,被视为极具前景的方案。
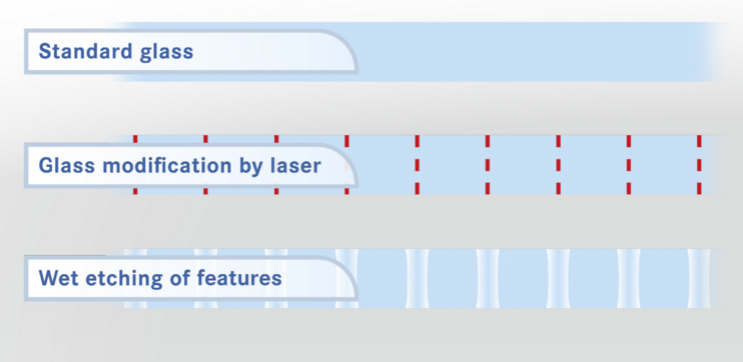
Source:LPKF
2、TGV的金属化
TGV 金属化流程独特,由于玻璃是绝缘材料且与金属粘附性差,省去沉积阻隔层的同时需增加黏附层,电镀液和电镀工艺与TSV不同。其金属化一般分为表面处理、黏附层、种子层和电镀铜四步。其中黏附层种类包括金属氧化物、PI、Ti/Cu(PVD)等,金属氧化物和PI黏附层是目前较为主流的方案。黏附层完成后再通过化镀或者PVD的方法形成种子层,最后电镀完成TGV的金属填充,这样就基本完成TGV金属化的整个过程。
目前代表性的方案包括有以下几种:
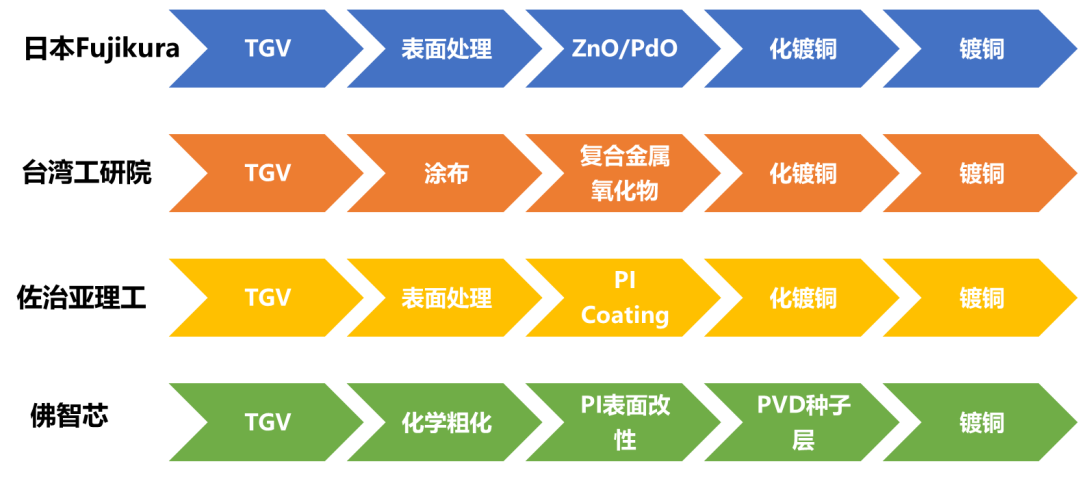
在黏附层的主流路线中,使用PI方案的企业包括佐治亚理工(Absolics)和佛智芯等,具备金属氧化物方案的企业包括安美特MKS-Atotech、日本OKUNO、Resonac等。
(1)PI方案,先对玻璃通孔进行表面处理,随后进行PI的涂覆,佛智芯使用PVD溅射Ti/Cu种子层,而佐治亚理工则使用化镀工艺。以佛智芯为例, PI表面改性的玻璃能有效防范微裂纹,同时金属化结合强度由1.67N/cm提升至8.26N/cm。
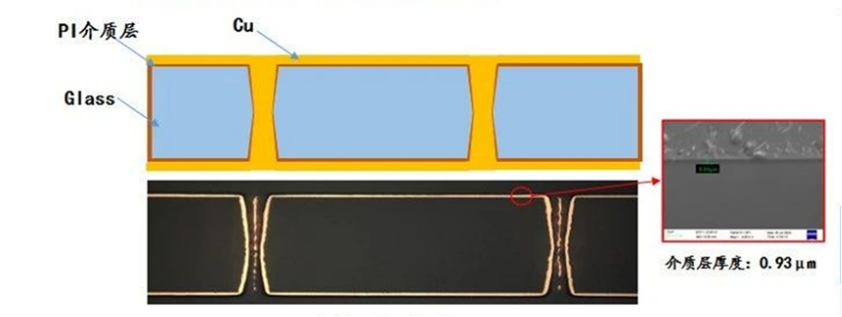
Source:佛芯微
(2)金属氧化物方案。安美特MKS-Atotech的VitroCoat GI®是一种超薄金属氧化物粘附促进剂,可通过湿化学方法在玻璃上形成金属沉积。其利用超薄金属氧化物粘附促进剂在玻璃上进行镀膜,可实现细致的L/S和优异的附着力,Cu与玻璃的结合强度达到7N/cm 以上。
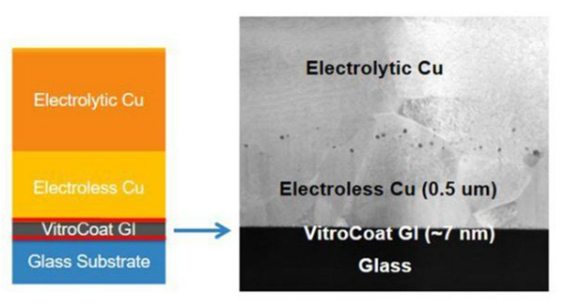
Source:MKS-Atotech
在完成黏附层和种子层后,还需要对TGV进行电镀填铜,与TSV常用bottom-up电镀方式不同,TGV电镀填充方式一般为BFT填充。

BFT填充
Source:《玻璃通孔三维互连镀铜填充技术发展现状》(纪执敬等,2022)
玻璃基板的RDL按照使用材料可以分为ABF和PID两种路线,铜布线的方法也分成半加成法和大马士革法,目前产品多以ABF+半加成法为主,未来随着L/S要求越来越高,PID路线+半加成/大马士革有望得到更多应用。
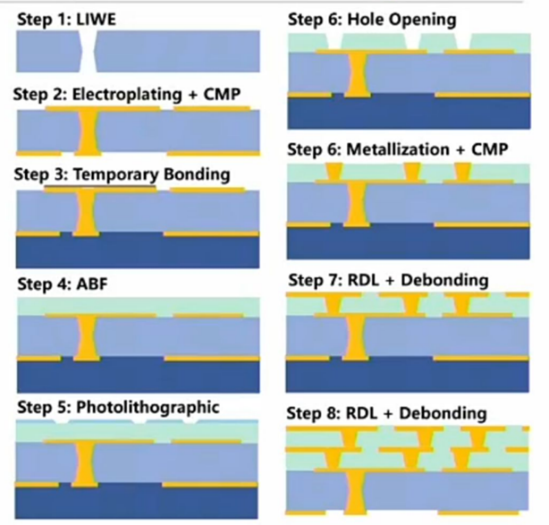
ABF+SAP方案
Source:三叠纪
六、结语
玻璃基板对比硅和有机载板优势显著,更低的介电常数、更短的互联长度使其能实现高速传输、高带宽密度和低能耗,还能解决Si interposer 面积受限问题,同时通过面板级封装可以降低成本。因此未来先进封装路线中必有玻璃基板的一席之地。
目前全球主要大厂均积极布局,且研发速度加快,预计2026年前后会是开始大规模商业化的时间点,与此同时玻璃基板的技术指标也在拔高。国内企业也在加速研发和试产进度,但技术能力稍显落后。
在玻璃基板商业化的过程中,制造端难题和产线匹配问题的解决需要新材料和新装备的支持,这为国内材料和设备企业创造了发展机遇,有望推动整个产业链协同发展,助力玻璃基板行业迈向新高度。
来源:战略规划办
编辑:文化宣传办
审核:肖彬




